随着中国制造业的转型升级,以科技创新为主导的新质生产力,正在引领各行业生产力革新及工业升级。在半导体行业中,激光已成为关键加工手段。根据 SEMI(国际半导体产业协会)的预测,2024年全球半导体设备总销售额预计将达到创纪录的 1,090亿美元,同比增长3.4%,同时,发展先进封装技术成为未来半导体功率器件行业发展趋势之一。
先进封装激光应用环节
近年来,德龙激光重点布局集成电路先进封装应用,在激光开槽(low-k)、晶圆打标的基础上,重点研发出玻璃通孔(TGV)、模组钻孔(TMV)、激光解键合等激光精细微加工设备,目前相关新产品已获得订单并出货。
德龙激光封测领域业务布局
重点设备
TGV激光微孔设备
设备主要应用于先进封装领域,是利用激光对晶圆玻璃进行改质加工,实现蚀刻成微孔的应用,本设备可以利用激光诱导不同材质 0.1-1mm 厚晶圆玻璃的微孔加工(TGV),可以实现各种尺寸盲孔、圆锥(通)孔的制备。
激光开槽/切割/钻孔一体机
设备是利用激光,针对半导体封装后的SiP产品进行打标、挖槽、切割(半切/全切)的全自动化设备。
激光解键合设备
设备利用激光,针对晶圆级封装产品当中临时键合Glass与Wafer的解键剥离。
激光辅助焊接设备
德龙激光激光辅助焊接设备主要应用在半导体封装领域,主要作用是将芯片与PCB基板焊在一起,把芯片内的电路引出。用激光焊接芯片只对芯片区域加热,不对整个基板加热,可以最大限度的减小产品热膨胀导致的变形,有助于提高芯片生产时的良率和可靠性。
Edge、Notch切割设备
设备针对晶圆级封装后的产品进行塑封层和RDL等结构进行周边裁切修剪。
晶圆(背面)打标设备
设备主要应用于先进封装段,是利用激光对晶圆上单个芯片Die进行字符等信息标记的全自动作业设备。可同时兼容FOUP/FFC两种方式上、下料,可同时满足裸晶圆和透膜两种打标工艺的要求,标准配置SECS/GEM功能,设备结构简洁运行稳定,于IC单颗封装产品,定位精准,具备印后检测及挑补功能。
此外,德龙激光以先进封装应用为引擎,在第十二届半导体设备与核心部件展示会(CSEAC 2024),携最新封装解决方案闪耀登场,持续驱动行业发展!
关于德龙激光
德龙激光(688170.SH)2005年由赵裕兴博士创办,位于苏州工业园区,2022年4月29日科创板上市。
公司是一家技术驱动型企业,自成立以来,一直致力于新产品、新技术、新工艺的前沿研究和开发。公司专注于激光精细微加工领域,凭借先进的激光器技术、高精度运动控制技术以及深厚的激光精细微加工工艺积淀,聚焦于泛半导体、新型电子及新能源等应用领域,为各种超薄、超硬、脆性、柔性及各种复合材料提供激光加工解决方案。同时,公司通过自主研发,目前已拥有纳秒、超快(皮秒、飞秒)及可调脉宽系列固体激光器的核心技术和工业级量产的成熟产品。
德龙激光肩负着“用激光开创微纳世界”的使命,致力于成为在精细微加工领域具备全球影响力的激光公司。
转载请注明出处。








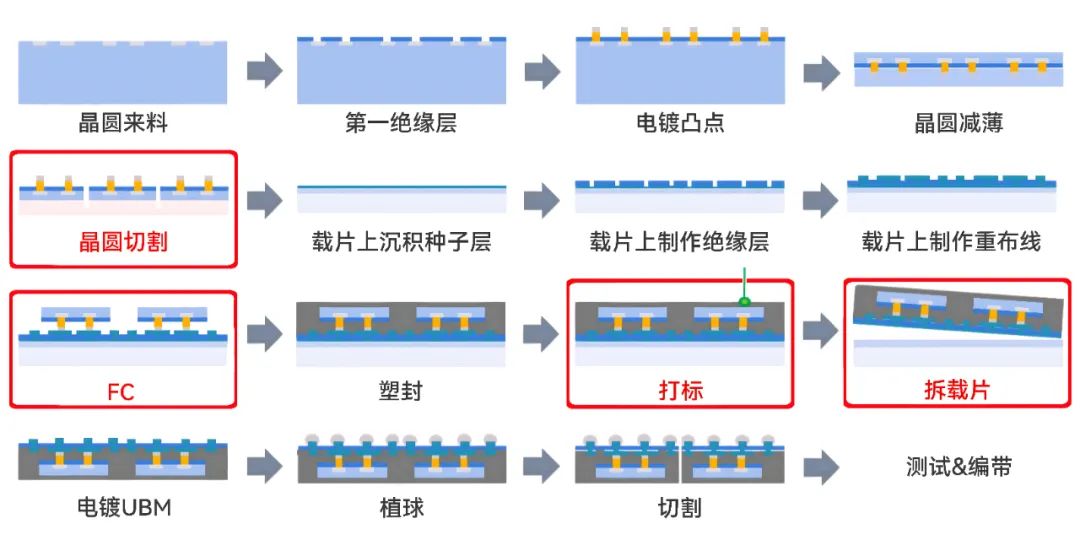


 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读
























 关注我们
关注我们




